一种简便的离子束刻蚀制备线性渐变滤光片的方法
线性渐变滤光片(LVOF)是继棱镜、光栅以及近期发展的多种分光元件之后发展起来的一种新型分光元件,它与棱镜、光栅等传统的分光元件相比具有体积小、通带多、通带位置可以任意设计等优点。由于线性渐变滤光片可与CCD/CMOS探测器列阵结合共同构成可识别光谱的探测器,大大简化分光系统,提高仪器的可靠性、稳定性和光学效率,受到越来越多的关注。以线性渐变滤光片为核心分光元件的光谱仪已经成功应用到航天航空、野外探测、大气监测、食品安全检测、生物流体分析和多/高/超光谱成像等多个领域,本文以法布里-珀罗结构滤光片为基础,提出一种简便的离子束刻蚀制备线性渐变滤光片的方法。

线性渐变滤光片
制备方法
在离子束出射窗口和待加工样片之间,垂直于离子束出射方向放置开有三角形窗口的挡板,离子束刻蚀时,样片以某一恒定速率来回运动,经过一定的刻蚀次数后,获得垂直于样品运动方向上的厚度差异,最终获得设计的楔形间隔层。
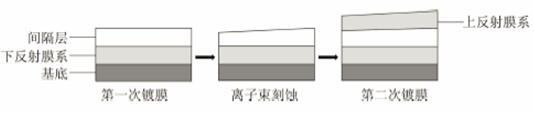
图1 LVOF加工流程示意图
线性渐变滤光片制备的完整工艺流程如图1。首先,在K9基底上进行第一次镀膜,将下层膜系和中间谐振腔层镀好;其次,按上述方法对中间层进行刻蚀,获得具有一定楔角的楔形谐振腔层;最后,配合第二次镀膜,即可完成线性渐变滤光片的制备。
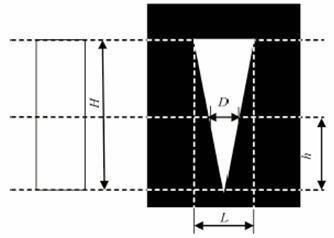
图2 离子束刻蚀示意图

图3 样品和挡板示意图
图2为离子束刻蚀过程示意图,图3为楔形谐振腔层各个参数示意图,三角形底边长度为L,三角形的高为H,沿样品台运动方向不同高度对应的开口宽度为D,对应的高为h,则D是关于h的函数,可表示为D(h) = Lh/H;不同高度对应的蚀刻深度可表示为W(h) = DvN/V = LhvN/(VH )。
式中v为介质材料在特定蚀刻条件下的蚀刻速率;V为样品台的运动速率;N为来回刻蚀的遍数。实验采用的挡板尺寸为L= 60 mm、H= 80 mm,样品刻蚀前,首先对谐振腔层材料的刻蚀速率进行标定,根据设计的蚀刻深度要求以及标定的材料刻蚀速率,计算出需要来回刻蚀的遍数,在离子束刻蚀机中设定好相关参数,刻蚀后即可获得预期的楔形谐振腔层。
滤光片制备
滤光片采用了尺寸为80 mm X 10 mm 的K 9基片。首先,需要完成下层反射膜系以及中间谐振腔层的镀制。谐振腔层厚度设计为670 nm。第一次镀膜完成后,进行样品刻蚀前的速率标定实验。实验均采用相同的离子源参数:加速电压500 eV、束流200 m A。分别设定工作气体参数为Ar(氩气)流量15 sccm(1 sccm =l mL/min)、Ar/CF4流量5/10 sccm,测定了两种条件下SiO2材料的刻蚀速率分别为1.33 nm/s和3.83 nm/s。
为提高刻蚀效率,选用Ar和CF4作为工作气体。设定工作气体参数Ar/CF4流量5/10 sccm,样品台的运动速率V=2 mm/s,该条件下要获得预期的470~630 nm 厚度范围的谐振腔层,样品来回刻蚀3遍即可。设计了刻蚀遍数N = l,2,3 三组谐振腔层刻蚀实验,不同的刻蚀遍数会产生不同的谐振腔结构,在滤光片性能上体现为具有不同的工作波段范围。多遍刻蚀时,每遍刻蚀之间间隔10~20 min以避免持续刻蚀产生的基片过热对材料刻蚀速率的影响。待三组样片谐振腔层刻蚀完成以后,进行第二次镀膜即上层膜系的镀制,镀制完以后,即完成了线性滤光片的制备。
结论
本文简便的离子束刻蚀制备线性渐变滤光片的方法,通过在离子束出射窗口和待加工样片之间加入特定形状挡板,通过控制挡板来回移动的速率和遍数,来获得设计的楔形谐振腔层结构,配合镀膜技术,即可完成线性渐变滤光片的制作。相比现有的滤光片制作方法,本文方法只涉及镀膜和刻蚀两种制备工艺,具有离子束刻蚀速率稳定可调控,楔形谐振腔层可自由设计,制备基本不受滤光片尺寸大小影响等特点,对于线性渐变滤光片的制作具有实际参考价值。
